您的位置:主页 > 公司动态 > 公司新闻 > 公司新闻
一颗小小的芯片,为何会发生那么大的热
滚烫的手机,温渡过高而死机的电脑,这些问题时常困扰着宽大的使用者们,这背后的缘故原由多数要归罪于芯片过热。现实上芯片的发烧问题不仅造成了使用上的未便,也给生产者们带来了伟大的手艺成本,并限制了芯片性能的进一步的提升。
一颗小小的芯片为何会发生那么大的热量?芯片的性能与发烧量有什么关系?工程师和科学家们又是用什么方式来解决这一问题?本文就将为你揭晓以上问题的谜底。
一,功耗是芯片的梦魇
1965年,英特尔首创人之一的戈登·摩尔提出了经典的摩尔定律, “每18个月性能提升一倍,价钱降低一半”,这条清规戒律就像一座路标,指引着行业生长的偏向与节奏。随之而来的就是更小的晶体管,频率更高的CPU,集成度更高的数字电路和更低的成本。一代又一代的芯片和电子产物由专用走向普及,并逐渐渗透到了生涯和事情的方方面面。
也正是云云,人们打开了数字天下的大门,看到了前所未见的光景。但与此同时,芯片性能的跃升也逐渐遇到了瓶颈……
以栅极氧化层为例,在接纳CMOS数字电路组织的CPU里,它起到要害的绝缘作用。栅极氧化层不仅要保证外面平整,不能有缺陷,为了相符半导体工艺尺度,它的厚度也有一个理论的上限值。当制程工艺由90nm向65nm过渡时,虽然芯片的集成度获得了提升,然则想要将小于2nm的这层栅极氧化层的厚度继续降低,却是十分难题。这一手艺难题让英特尔这样的芯片巨头也为之头疼。
随着芯片的加工工艺精度进入原子级别,任何缺陷都被会被无限放大,好比在内部结构中仅仅缺少一个原子的厚度,就可能引起异常大的泄电流,这样的泄电流不仅白白虚耗了电能,更是引起芯片严重发烧的缘故原由。以早期的英特尔飞跃四CPU为例,有一半的功耗就是由于泄电被虚耗了。
现在的CPU的单核速率可到达4GHz,算力的提升也带来了功耗和发烧量的水涨船高,这时若是还照方抓药式地接纳传统的风扇降温,CPU内部的热量就会迅速攀升甚至将其融化。为了兼顾算力和功耗,工程师则接纳了双核芯片及多核的方式,走多核芯片蹊径以分管单颗CPU的事情负荷间从而降低功耗和发烧。除此以外,往后质料的刷新,也能够对功耗和散热起到了异常大的优化作用。
二,神秘的测试
测试是磨练真理的唯一尺度。就像学生时代的临考前,先生们千吩咐万嘱咐的一句话:做完问题别着急交卷,先检查检查,在半导体制造历程中更是云云,从芯片的制造到交支出货时代,芯片测试已成为了不能或缺的环节。
在所有电子元器件的制造工艺内里,存在着去伪存真的需要,为了实现试验的历程,就需要种种试验装备,这类装备就是所谓的ATE(Automatic Test Equipment)。
ATE是一种通过盘算机控制,举行芯片、电路板和子系统等测试的装备,通过盘算机编程取代人工劳动,自动化地完成测试序列。ATE的应用场所涵盖集成电路整个产业链,主要包罗了芯片的设计验证、晶圆制造相关的测试到封装完成后的制品测试。
ATE市场的生长可以追溯到1960年月,早期的半导体测试装备生长并不完全是由自力的装备商指导,而是由半导体制造公司主导。仙童半导体(Fairchild)、德州仪器(TI)等制造企业生产ATE都是用于内部使用,而从1980年月起,ATE领域最先举行整合,2011年惠瑞捷(VERIGY)被收购后,形成了以泰瑞达(Teradyne)和爱德万测试的双寡头名目。
回首ATE的生长史,可以说泰瑞达是“第一个吃螃蟹的人”。早在1960年,两位麻省理工高材生在波士顿确立了泰瑞达公司。现在,在波士顿总部的展示区域,依旧陈列着天下上第一台ATE装备D133,它是1961年推出的第一台二极管测试机,标志着自动测试装备迈入全新纪元。Teradyne(泰瑞达)的命名颇有意思,名字中的"Tera"取自10的12次方的前缀,"dyne"是力学的单元。云云命名,也意味着这家公司将是一股不容小觑的伟大气力。
从70年月到80年月早期的十年间,集成电路履历了由小规模到中规模再到大规模和超大规模的变迁。这时盘算机控制的测试系统成为主要的测试装备。80年月中期,随着门阵列器件的乐成开发,对于测试方面要求到达了256管脚,速率高于40MHz。进入到90年月,单片处置器单元(MPU)的问世也带来了高速高管脚数的ATE。随后多媒体器件的泛起使ATE变得加倍庞大,需要同时具有数字电路、模拟电路和存储器电路的测试能力。
近年来,工艺节点不停提升,芯片制程工艺不停迫近物理极限,这些也带来了更高的集成度。随之而来,整个芯片的功耗方案也要作出相对应的改变。
当下,先进制程芯片具有异常庞大的供电系统,测试成本不停增添的同时,测试环节对产物良率的监控将会愈发主要,这样的情形下,ATE该若何测试?
三,现实测试中的挑战
现实测试中的挑战
应用处置器的测试机里有两个异常主要的单元,其一是数字芯片测试的数字I/O,数字I/O肩负了相对庞大的事情,可以抓取失效;另一个就是电源,虽然DC电源看起来对照简朴,但在现实的大功率处置器的测试中,电源在起到异常主要的作用,由于它决议了测试质量,最终测试的良率也与电源的现实性能息息相关。
睁开来看,应对差其余挑战,差异测试环节的测试参数和应用场景稍有区别,就需要接纳差其余解决方案。
对于庞大的供电问题,行使模块化的供电战略可以降低多相位庞大供电的困扰。通过天真地分配测试资源,将电源拆解成一个个小的电源模块,随便组合成小的单元模块给差其余电源轨供电,同时还可以行使冗余的电源模块来辅助已经预设好的模块降低供电电源轨的稳压压力。
简朴举例,一个需要30安培的VDD引脚,若是每个通道支持5安培的输出能力,可以组合6个这样的单元来供电,同时行使冗余的通道组合单元与前面的6个单元组合在一起降低供电压力。
此外,还可以行使软件编程的方式设定上电顺序、软启动等,以削减外围供电电路。
对于大多数应用处置器来说,事情频率与VDD一样平常出现正相关性。在前期的设计验证中,厂商会实验寻找sweet point使得芯片在有限的功耗下显示出更好的性能,在现实的生产测试中,可能会直接地设定一个指定的VDD,看其能否在这个特定的VDD下到达预期的频率。

数据整理来自泰瑞达
然而,在现实的测试中,没有一款测试机是完善的。现实操作中,芯片会经常性发生误差,一种方式是实验编程稍高于芯片预设值的电压,由于思量芯片的误差及所有的消耗,需要保证芯片引脚上的电压依然高于预期值。通过这种测试方式,纵然仪表颠簸到最低的电压情形下,质量好的器件仍然可以pass,从而获得更高的良率。
另一种方式,直接将测试仪表的输出编程即是预期值,由于现实上一些测试机并不能到达优越的精准度,在一些情形下略低于输出,导致这部门的芯片现实测试电压低于预期值。
这两种方式会造成差其余负面效果。在第一种的情形下,VDD的预期值需要制订得更高一些,这样的话现实的电压会高于预期值,现实测试中的热消耗也会更大,在测试中就需要低速的向量辅助降温。
第二种情形下,虽然现实出货的产物都能够pass预期值,然则对于一些误差对照大的机械,会造成分外的良率损失。对于7nm、5nm的先进制程产物来说,良率是极其主要的一个因素,由于先进制程产物尤其是晶圆面积较大时的良率自己异常低,在此基础上若是又分外损失一部门良率,这对于器件制造成本是难以接受的。
面临种种挑战,我们该若何测试?测试机应该具备怎样的特征知足以上的诸多挑战需求呢?
四,差异测试挑战的有的放矢
“Millivolts Matter”,每一个毫伏的精度都异常主要。越来越低的焦点电压对电源的输出精度,以及动态响应提出了越来越高的要求。泰瑞达一直把电源仪表的输出电压能力作为仪表设计最主要的参数之一,这也是泰瑞达区分于众多ATE厂商的特征之一。
在现实测试历程中电源的供电不是完全平展的,现实的电源功耗与现实工况有很大关系,甚至会导致芯片丢失状态,从而导致器件失效。这样的问题既难展望又很难排查。
通过不停改变输出的VDD与Scan Shift频率来查看所有测试向量的输出效果,当VDD越低频率越高时,越容易发生失效。在现实的Shmoo测试案例中,泰瑞达的UltraFLEXplus具有更稳固的供电电源,这意味着可获得更高的界限良率,使得芯片加倍贴近于真实的本征。这样一来,在现实产物中,我们对于芯片的现实工况便能够获得一个加倍准确的推断,知道哪些情形是可以事情的,哪些情形是不能事情。总的来说,更好更稳固电源不仅能够提升良率,还能够熟悉芯片在真正工况下的事情状态。
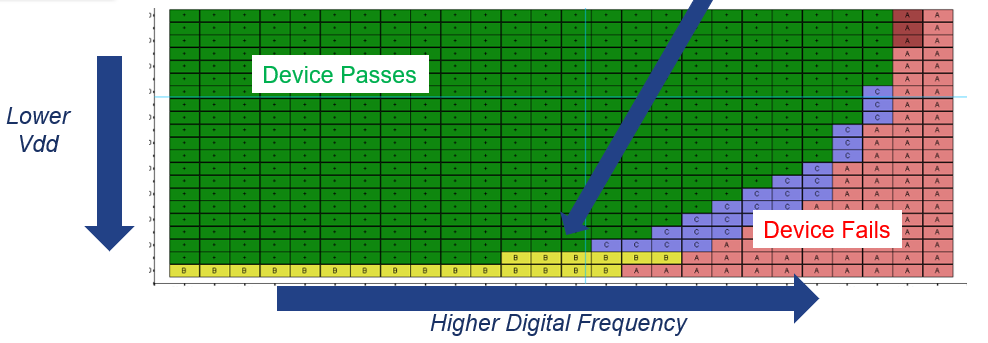
数据整理来自泰瑞达
现在,许多芯片需要异常大的电流供电能力,输出一个异常大的电流能力对测试机来说已经不是一个难题了,许多测试机已经能够轻松供应1000A的输出能力。然而多工位测试的时刻每个芯片的单个电源轨上电都要到达800 -1000A,测试机虽然能够知足1000A的静态供电,它是否能够知足0A到1000A的单步上电历程,成为了一个难题。在多工位测试的时刻,泰瑞达所提供的解决方案就能够知足单步上电的大电源供应。

数据整理来自泰瑞达
除了关注电源静态、动态的部门,在电源的外围电路设计上,socket、探针卡、loadboard等与电源的性能也是息息相关。
测试仪表的动态响应对直流电源的显示影响异常大,优异的电源方案可以辅助削减外围电源电路的庞大度。传统的ATE解决方案首先需要板卡提供能量供应,大多供应从直流部门到100kHz的频域局限,针对低频、中频、高频等其他频段也需要增添纷歧样的外围电路,致使整体电路对照庞大。
泰瑞达偏重于简化电路设计,通过ATE自己就能提供从低频到中频的输出能力,不需要增添分外的外围电路,尽可能削减电容数目。在现实操作中,只需加入较少种类的低ESR/ESL陶瓷电容来辅助改变高频特征,令单个型号就可知足输出的动态性能。
这样的利益在于:1)降低电容值以加速恢复时间;2)电容少意味着充放电时间更快,也就意味着充放电的能量会变少,这样可以加速测试时间并降低socket被能量损伤的概率;3)降低电容使用种类,在使用单一电容的情形下,可以降低电路发生谐振、慢恢复等的可能性。
另一个对照大的挑战在于测试单元,大功率的先进制程芯片功率耗散异常大,多数输出的能量最终都市转化为热量。我们在测试时要阻止芯片无限制地升温导致芯片“被烧坏”,而是希望在测试参数的时刻做到可重复、可重现,使芯片维持在稳固的情形下测试,保证所有收取数据的一致性。最直接的设施可接纳在测试单元的时刻使用ATC(Automatic Temperature Control),常见的设施有三种:方案一)DUT Power Monitor;方案二)Die Temperature Monitor;方案三)Package Temperature Monitor。

数据整理来自泰瑞达
三种方式各有利弊,在时间上的效益也差异(如上图),泰瑞达加倍倾向于使用方案一,其优点在于可以更早预判芯片接下来可能发生的状态并提前介入;其次,泰瑞达测试机原身也能够支持这种方式,输出每一个DPS当下负载的百分比以及输出电压的巨细。
在许多现实量产的案例中,泰瑞达已经使用了这种监控方式,对譬喻案二、三可以更早预知芯片的现实工况。
芯片功率不停加大的情形下电路变得加倍庞大,我们希望在测试的历程中所有的socket、探针卡、loadboard等都能获得对照好的监控,保证在短路、接触不良等异常情形发生时不会因此而损坏测试部件。
为阻止这种情形发生,泰瑞达在设计大部门测试板卡的历程中会添加实时的报警机制,一旦任何异常发生,能够在不影响其他装备生产和中止生产的情形下,通过测试机作出实时忠告,提前筛查阻止异常情形的泛起,削减测试漏测、质量事故等情形的发生。
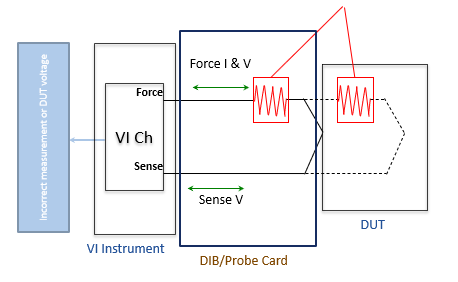
数据整理来自泰瑞达
总结
半导体测试就是通过丈量半导体的输出响应、预期输出、并举行对照以确定或评估集成电路功效和性能的历程,贯串设计、制造、封装、应用全历程。随着半导体制造工艺要求的提升,测试环节在半导体制造历程中的职位随之不停提升。
半导体测试机的手艺焦点在于功效集成、精度与速率、降低成本与可扩展性。在泰瑞达看来,测试解决方案要有足够好的静态精度及稳压能力,同时在界限情形下获得更好的鲁棒性来辅助降低失效的概率;尽可能简化外围电路的设计,降低运营方面的损失,侧面降低测试成本;最后加入警报机制来提前预判,阻止发生异常情形。

